МЕТОДИЧЕСКИЕ УКАЗАНИЯ
9.3. p-n переходы
Прогресс в развитии полупроводниковой микроэлектроники в значительной степени связан с использованием контакта двух примесных полупроводников с различным типом проводимости. Такой контакт называют электронно – дырочным переходом или p – n переходом. Существуют различные технологии создания p – n переходов. Мы рассмотрим гомопереход, который реализуется в виде границы между областями с различным типом проводимости в одном и том же полупроводнике.
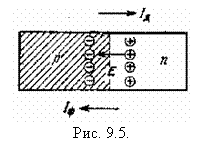
Обратим внимание на различие уровней Ферми в областях с различным типом проводимости (см. рис. 9.3). Очевидно, что при контакте электроны будут переходить из области n – типа в область p – типа, а дырки – в обратном направлении, пока в образцах не сравняются уровни Ферми. Электроны и дырки, попавшие в результате диффузии в “чужие” области, рекомбинируют со свободными носителями противоположного знака.
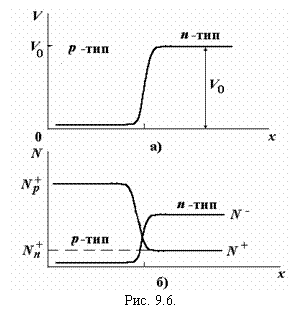
За счет диффузионного ухода части носителей как в n-, так и в p – области возникают нескомпенсированные ионные заряды из донорных и акцепторных атомов. В n- слое нескомпенсированный заряд положителен, а в р – слое отрицателен. Поэтому вблизи p – n – перехода образуется двойной электрический слой, называемый запирающим слоем, создающий внутри перехода электрическое поле, направленное из n – области в р – область (рис. 9.5). Это поле затрудняет диффузию носителей и приводит к падению диффузионного тока. Другими словами, между областями с p – и n – типами проводимости устанавливается контактная разность потенциалов U0 (рис. 9.6, а), равная разности исходных уровней Ферми, которая в свою очередь близка к ширине запрещенной зоны.
Под действием тепловых флуктуаций во всем объеме кристалла время от времени рождаются пары электрон – дырка (собственные носители). Появившиеся свободные электроны в р – области и свободные дырки в n – области выталкиваются из этих “чужих” областей нескомпенсированными ионными зарядами в “свои” области. В результате возникает флуктуационный ток Iф, направленный противоположно диффузионному току Iд (рис. 9.5). При тепловом равновесии Iд = Iф = I0 (9.8)
Сначала рассматриваем ток, возникающий благодаря дыркам, а потом обсудим, как образуется ток отрицательных носителей заряда. Величина флуктуационного дырочного тока пропорциональна концентрации дырок ![]() в образце n - типа. При пересечении дырками поверхности контакта они будут ускоряться разностью потенциалов U0. Таким образом,
в образце n - типа. При пересечении дырками поверхности контакта они будут ускоряться разностью потенциалов U0. Таким образом, ![]() (9.9), где С -коэффициент пропорциональности. Аналогично диффузионный ток дырок
(9.9), где С -коэффициент пропорциональности. Аналогично диффузионный ток дырок ![]() пропорционален произведению концентрации дырок
пропорционален произведению концентрации дырок ![]() , но в области р – типа, на долю дырок, которые могут преодолеть потенциальный барьер. Эта доля, учитывающая вырожденный характер дырочного газа, находится в рамках классической статистики Больцмана и равна
, но в области р – типа, на долю дырок, которые могут преодолеть потенциальный барьер. Эта доля, учитывающая вырожденный характер дырочного газа, находится в рамках классической статистики Больцмана и равна ![]() . Следовательно,
. Следовательно,
Учитывая (9.8), (9.9) и (9.10), мы имеем
Приложим теперь к p - n переходу внешнюю разность потенциалов. Если при этом n – слой кристалла соединяется с положительным электродом источника, а p – слой – с его отрицательным электродом (рис. 9.6, а), то внешнее электрическое поле будет оттягивать электроны из n – области и дырки из р – области от контакта. В этом случае единственно возможным будет только флуктуационный ток I0 = Iф. Соответствующий ток также называется обратным или током неосновных носителей. Но он очень мал, потому что из – за тепловых флуктуаций пары электрон – дырка рождаются редко и в среднем далеко от p – n перехода. Если же положительный электрод источника соединить с р слоем, а отрицательный – с n слоем (рис. 9.7, б), то картина существенно изменится. Внешнее поле будет подгонять носители к переходу. В результате резко возрастает диффузионный ток. Он в данном случае называется прямым током основных носителей. Деление на токи основных и неосновных носителей обусловлено тем, что в заданном температурном интервале число примесных носителей тока значительно превосходит число собственных носителей.
 Разность потенциалов между областью n – типа и областью р – типа станет равной U0 – U, где U – внешнее напряжение. Прямой дырочный ток можно записать в виде:
Разность потенциалов между областью n – типа и областью р – типа станет равной U0 – U, где U – внешнее напряжение. Прямой дырочный ток можно записать в виде:
А результирующий ток дырок через p – n переход будет равен
Если рассмотреть ток электронов проводимости, обусловленный концентрациями ![]() и
и ![]() отрицательных носителей, то все выкладки в этом случае абсолютно те же, что и выполненные выше, и приводят к тому же результату, а именно к формуле (9.12), в которой можно индексы + заменить на -. Если принять во внимание наличие отрицательных носителей заряда, то токи I и I0 представляют собой максимальные токи, создаваемые носителями обоих знаков и формулу (9.12) можно записать в виде
отрицательных носителей, то все выкладки в этом случае абсолютно те же, что и выполненные выше, и приводят к тому же результату, а именно к формуле (9.12), в которой можно индексы + заменить на -. Если принять во внимание наличие отрицательных носителей заряда, то токи I и I0 представляют собой максимальные токи, создаваемые носителями обоих знаков и формулу (9.12) можно записать в виде
где I– результирующая сила тока в p – n переходе, I0 – предельное значение силы обратного тока, U – внешнее напряжение, приложенное к p – n переходу.
На рис. 9.8 приведена зависимость I от U, вычисленная по формуле (9.13). Следует заметить, что при положительном напряжении ток, как правило, во много раз превосходит величину I0, в то время как при обратном напряжении максимальный ток равен I0. Устройство, обладающее такой нелинейной вольт – амперной характеристикой, называется диодом.

Помимо гомопереходов в полупроводниковой элкетронике важную роль играют гетеропереходы. Гетеропереходом называется полупроводниковый переход между двумя разнородными по основному химическому составу или (и) фазовому состоянию полупроводников. Примерами контактов, используемых для образования гетеропереходов, являются Ge – Si, GaAlAs – GaAs, GaAs – Ge, InGaAs – InPи другие.P – n - гетеропереходы называют анизотипными. Кроме анизотипных гетеропереходов используются и изотипные гетеропереходы между полупроводниками с каким – либо одним типом проводимости. Комбинации различных гетеропереходов образуют гетероструктуры. При этом разработана технология получения многослойных структур типа сверхрешеток с толщиной слоев менее 10 нм.
Главная особенность гетеропереходов по сравнению с гомопереходом состоит в скачкообразном изменении каких либо свойств на граничном контакте полупроводников: ширины запрещенной зоны, подвижности носителей заряда, их эффективной массы, энергии сродства к электрону, можно изменять соотношения между потоками носителей заряда, например, создавать практически одностороннюю инжекцию носителей заряда, в отличие от рассмотренного выше p – n гомоперехода, где основную роль играет различие в концентрациях примеси. Скачкообразное изменение свойств гетеропереходов и возможность целенаправленного управления этими свойствами подбором сопрягаемых полупроводниковых материалов позволило придать на основе гетеропереходов совершенно новые и необычные свойства традиционным полупроводниковым приборам (диодам, транзисторам, фотоэлементам, светоизлучающим диодам и т.д.) и создать оригинальные гетеропереходные полупроводниковые приборы, в частности, гетероинжекционные. В России были созданы первые в мире гетероинжекционный лазер (1968) и лавинно – пролетный диод на гетеропереходе (1970). Большой вклад в создание целого ряда гетеропереходных полупроводниковых приборов внес научный коллектив под руководством Ж. И. Алферова. В 2000 году академик Ж. И. Алферов был удостоен Нобелевской премии по физике.