

Лекция №5
Методы исследования наноструктурных материалов
5.1 Электронная микроскопия
5.2 Дифракционные методы
Существуют некоторые различия в подходах к исследованию свойств частиц на поверхности и в объеме.
К основным методам определения размера и некоторых свойств частиц в газовой фазе относятся:
- ионизация фотонами и электронами с последующим анализом получаемых масс-спектров на квадрупольном или время-пролетном масс-спектрометре;
- атомное распыление и осуществление селекции по массам нейтральных кластеров;
- электронная просвечивающая микроскопия на сетках (информация о размере и форме частиц).
Для получения информации о частицах на поверхности используются:
- просвечивающая и сканирующая электронная микроскопия (информация о размере/форме частиц, их распределении и топологии);
- дифракция электронов (информация о размере, фазе - твердая/жидкая, о структуре и длине связи);
- сканирующая туннельная микроскопия (определение размера, формы частицы и внутренней структуры);
- адсорбция газов (информация о площади поверхности);
- фотоэлектронная спектроскопия (определение электронной структуры);
- электропроводность (информация о зоне проводимости, перколяции, топологии).
Для определения размера и некоторых свойств частиц в объеме или матрице также используются различные методы:
- просвечивающая электронная микроскопия (ПЭМ)
- сканирующая электронная микроскопия (СЭМ),
- рентгеноструктурный анализ (РСА)
- электропроводность,
- дифракция электронов .
Расширенная тонкая структура и адсорбция рентгеновских лучей позволяют определять размер частиц, а методы электронного парамагнитного резонанса (ЭПР) и ядерного магнитного резонанса (ЯМР) дают информацию об электронной структуре. Для определения внутренней структуры ряда элементов активно используется мессбауэровская спектроскопия, или резонансное поглощение гамма-квантов ядрами атомов твердого тела (гамма-резонанс). Особенно актуальна возможность исследования мессбауэровской спектроскопией такого важного элемента как железо. Энергия гамма-квантов невелика (~150 кэВ), когда гамма-квант поглощается, то ядро возбуждается. Условие резонанса - равенство энергии возбуждения ядра энергии квантового перехода, т.е. разности внут ренней энергии ядра в возбужденном и основном состоянии. Энергия перехода зависит от природы ядра и дает информацию о микроскопической структуре твердых тел. Однако метод применим не ко всем элементам .
Для изучения топографии поверхности пленок и изломов применяют сканирующий электронный микроскоп и атомно-силовой микроскоп.
Таким образом, методы ПЭМ и РСА - это основные методы изучения структуры материалов. В отдельных случаях используют спектры комбинационного рассеяния (рамановская спектроскопия) (на пример, для определения диаметра графитовых нанотрубок), мессбауэровская спектроскопия (для измерения, например, размера кластеров железа по интенсивности линий спектра), измерение объема сорбированных газов (для определения эффективных диа метров открытых нанопор и наночастиц), рентгеновская абсорбционная спектроскопия (для расчета координационных чисел из экспериментальных кривых радиального распределения атомов), малоугловое рассеяние рентгеновских лучей и нейтронов (для оценки распределения наночастиц и нанопор по размерам) и др.
5.1 Электронная микроскопия
Микроскопия является основным методом определения раз мера частиц и зерен, поэтому рассматривается более подробно. При этом, как правило, используются электронная микроскопия, при меняющая луч из пучка ускоренных электронов, и различные варианты зондовых микроскопов.
Измерение размера структурных составляющих материа лов осуществляется электронно-микроскопическими методами с помощью изображений прямого разрешения и темнопольных изображений с компьютерной обработкой результатов измерений для массивов, содержащих обычно не ме нее 1000 — 2000 кристаллитов. При измерении размеров зерен, а также размеров частиц, включений и пор принято оце нивать следующие параметры: средний диаметр этих объектов по их числу L n , средний линейный диаметр L l средний диаметр по поверхности (или диаметр эквивалентной окружности) L s и сред ний диаметр по объему (или диаметр эквивалентной сферы) L v :
![]() ,
,
![]() ,
,
![]() ,
,
![]() ,
,
где п — число зерен или других объектов i -го размерного класса. Данные с оотношения получены для элементов сферической формы.
В силу особенностей методики измерений электронно-микро скопический анализ дает информацию о среднем диаметре частиц по их числу ( L n ) или о среднем диаметре по поверхности ( L s ), a PCA дает сведения о диаметре эквивалентной сферы ( L v ). Между этими параметрами существуют определенные соотношения: L v > L s > L l > L n .
Во многих случаях распределение зерен по размерам имеет нор мальный или логарифмически-нормальный характер и подчиняется известным соотношениям:
 ,
,
 ,
,
где F Н ( L ), F ЛН ( L ) — соответственно нормальная и логарифмически-нормальная функции распределения;
![]() ,
, ![]() — среднеквадра тичная соответственно арифметическая и геометрическая ошибка (отклонение);
— среднеквадра тичная соответственно арифметическая и геометрическая ошибка (отклонение);
![]() ,
, ![]() — среднее соответственно арифметическое и геометрическое значение.
— среднее соответственно арифметическое и геометрическое значение.
В отличие от равномерного распределения данных в случае F Н при логарифмически-нормальном распределении имеет место кру той спад в области значений L < ![]() и пологое изменение при L >
и пологое изменение при L > ![]() .
.
Экспериментальные данные в основном соответствуют FЛН и с огласование результатов, полученных методами ПЭМ и РСА, в ос новном удовлетворительное (результаты отличаются на 10 — 15 %); причем практически всегда L пэм < L рса, но согласованность не сколько ухудшается при переходе к более мелким объектам ( L ![]() 10 нм). Однако следует иметь в виду, что с помощью ПЭМ информация о L регистрируется с гораздо меньшего участка исследуемого материала, чем в случае РСА. Таким образом, метод РСА дает более усредненную картину. Реально наблюдаются различные смешанные варианты FН и FЛН , а также случаи бимодального распределения, когда на графике плотности распределения кристаллитов по размерам имеется не один, а два максимума. Изучение распределения зерен по размерам важно для уточнения характера соотношений типа свойство- параметры структуры. Следует иметь в виду, что хотя количество крупных зерен в структуре может быть невелико, их объемная доля может быть значительной и это необходимо учитывать при анали зе свойств материалов. Кроме того, распределение зерен по размерам отражает технологические особенности получения материалов и во многом определяет их термическую стабиль ность. Так, если для ультрадисперсного порошка, полученного, например, методом испарения — конденсации, наблюдается нор мальное распределение частиц по размерам, то это свидетель ствует о росте частиц путем присоединения одиночных атомов (конденсационный механизм), а при логарифмически-нормальном распределении превалирует коалесценционный механизм, когда рост частиц осуществляется за счет их объединения. В то же время наличие широкого распределения зерен по размерам в материалах — предпосылка для интенсивного увеличения раз мера зерен при нагреве, поскольку большие зерна в структуре являются как бы зародышами для аномального роста за счет по глощения ими мелких собратьев.
10 нм). Однако следует иметь в виду, что с помощью ПЭМ информация о L регистрируется с гораздо меньшего участка исследуемого материала, чем в случае РСА. Таким образом, метод РСА дает более усредненную картину. Реально наблюдаются различные смешанные варианты FН и FЛН , а также случаи бимодального распределения, когда на графике плотности распределения кристаллитов по размерам имеется не один, а два максимума. Изучение распределения зерен по размерам важно для уточнения характера соотношений типа свойство- параметры структуры. Следует иметь в виду, что хотя количество крупных зерен в структуре может быть невелико, их объемная доля может быть значительной и это необходимо учитывать при анали зе свойств материалов. Кроме того, распределение зерен по размерам отражает технологические особенности получения материалов и во многом определяет их термическую стабиль ность. Так, если для ультрадисперсного порошка, полученного, например, методом испарения — конденсации, наблюдается нор мальное распределение частиц по размерам, то это свидетель ствует о росте частиц путем присоединения одиночных атомов (конденсационный механизм), а при логарифмически-нормальном распределении превалирует коалесценционный механизм, когда рост частиц осуществляется за счет их объединения. В то же время наличие широкого распределения зерен по размерам в материалах — предпосылка для интенсивного увеличения раз мера зерен при нагреве, поскольку большие зерна в структуре являются как бы зародышами для аномального роста за счет по глощения ими мелких собратьев.
Таким образом, для получения достоверной информации о размерах кристаллитов и их распределения необходимо использовать как минимум два независимых метода.
В электронной микроскопии имеется два основных направления:
- просвечивающая электронная микроскопия (ПЭМ), в которой в последнее время принято выделять в отдельный раздел электронную микроскопию высокого разрешения;
- растровая сканирующая электронная микроскопия (СЭМ).
5.1.1 Просвечивающая электронная микроскопия
Объект, представляющий собой тонкую пленку, просвечива ется пучком ускоренных электронов с энергией 50-200 кэВ в вакууме порядка ![]() . Электроны, отклоненные атомами объекта на малые углы и прошедшие сквозь объект, попадают в систему магнитных линз, которые на экране и на фотопленке формиру ют светопольное изображение внутренней структуры. Достигает ся разрешение в 0,1 нм, что соответствует увеличению в
. Электроны, отклоненные атомами объекта на малые углы и прошедшие сквозь объект, попадают в систему магнитных линз, которые на экране и на фотопленке формиру ют светопольное изображение внутренней структуры. Достигает ся разрешение в 0,1 нм, что соответствует увеличению в ![]() раз.
раз.
Разрешение зависит от природы объекта и способа его подготовки. Обычно исследуют пленки толщиной 0,01 мкм, для увеличения контрастности применяют углеродные реплики. Современные ультрамикротомы позволяют делать срезы толщиной 10 -100 нм. Металлы исследуют в виде тонкой фольги. С помощью просве чивающих микроскопов можно получать дифракционные картины, дающие информацию о кристалличности объекта.
5.1.2 Сканирующая электронная микроскопия (СЭМ)
Этот метод в основном применяется для изучения поверхност ных частиц. Электронные лучи сжимаются магнитными линзами в тонкий (1- 10 мм) зонд, который последовательно от точки к точке перемещается по объекту, т.е. сканирует его. При взаимодействии электронов с объектом возникает несколько видов излучений:
- вторичные и отраженные электроны,
- прошедшие электроны,
- рентгеновское тормозное излучение,
- световое излучение.
Любое из перечисленных излучений может регистрироваться и преобразовываться в электрические сигналы. Полученные сигналы усиливаются и подаются на электронно-лучевую трубку. Аналогичная ситуация имеет место в кинескопе телевизора. На экране формируется изображение, которое фотографируют.
Основное достоинство метода - высокая информативность, а существенный недостаток - большая длительность процесса. Высокая разрешающая способность реализуется лишь при малых скоростях развертки.
Метод обычно применяется для частиц размером больше 5 нм. Проблема связана с ограничивающей применение толщиной образца. Для электронов с энергией 100 кэВ толщина образца составляет около 50 нм. Чтобы предотвратить разрушение образцов, используют специальные приемы их приготовления. Кроме того, всегда приходится иметь в виду возможность лучевой нагрузки на образцы, например, может происходить агрегация частиц под лучом.
Одним из способов подготовки образцов является применение ультрамикротомов (их использование затруднено при неравномерном, например островковом, осаждении). Применяются также химические методы, в частности растворение матрицы. Вид получаемой при микроскопическом исследовании гистограммы часто зависит от метода получения образца.
В 80-х гг. XX столетия в электронной микроскопии произошел мощный прорыв. Были созданы микроскопы с компьютерным анализом элементного состава на базе спектрометра энергетических потерь. Спектрометрию энергетических потерь применяли в комбинированных ПЭМ и СЭМ. Перекомпоновка системы магнитных призм позволила регулировать контрастность изображения, которая зависит от угла падения, атомного номера и коэффициента отражения. В настоящее время на современных приборах можно получать селективные изображения элементов от бора до урана с разрешением 0,5 нм и чувствительностью до 10 - 20 г , что для кальция, например, составляет 150 атомов. Получать информацию о подобных объектах позволяет электронная микроскопия высокого разрешения.
Важный этап в развитии электронной микроскопии связан с разработкой методов компьютерной обработки изображений, позволяющей получать гистограммы по форме, ориентации и размерам. Можно выделять детали структуры, проводить статистическую обработку, рассчитывать локальные микроконцентрации, определять параметры решеток. Встроенные в приборы процессоры дают возможность гибко управлять микроскопами.
В сканирующих электронных микроскопах высокого разрешения изображение рельефа получают при сканировании пучком электронов по поверхности образца. Использование специальных катодов с полевой эмиссией значительно повышает эффективность получения качественных изображений с разрешением 1 – 1,5 нм.
5.1.3 Зондовая микроскопия
Еще один прорыв в микроскопии связан с созданием сканирующих зондов. В 1981 г. Бинниг и Рорер создали сканирующий туннельный микроскоп (СТМ, или ЗТМ), а в 1986 г. они получили Нобелевскую премию. Микроскоп позволяет вести исследо вание поверхности с нанометровым и субнанометровым простран ственным разрешением. Общим для всех сканирующих зондовых микроскопов является способ получения информации о свойствах исследуемой поверхности.

Gerd Binnig и Heinrich Rohrer
В данном методе свойства поверхности образцов изучаются путем приложения небольшого напряжения (0,01 – 10 В) и регистрации туннельного тока в зазоре (примерно несколько атомных диаметров) между электропроводящим острием (зондом) и исследуемой поверхностью металлов, полупроводников и других проводящих материалов. Туннельный ток зависит от химического состава и особенностей рельефа. Эта информация дополняется данными спектроскопических измерений.
Основная деталь таких микроскопов - зонд, который приводится в механический или туннельный контакт с поверхностью. При этом между зондом и образцом устанавливается баланс взаимодействий. Этот баланс может включать силы притяжения и отталкивания (электрические, магнитные, ван-дер-ваальсовы), процессы обмена туннелирующими электронами, фотонами.
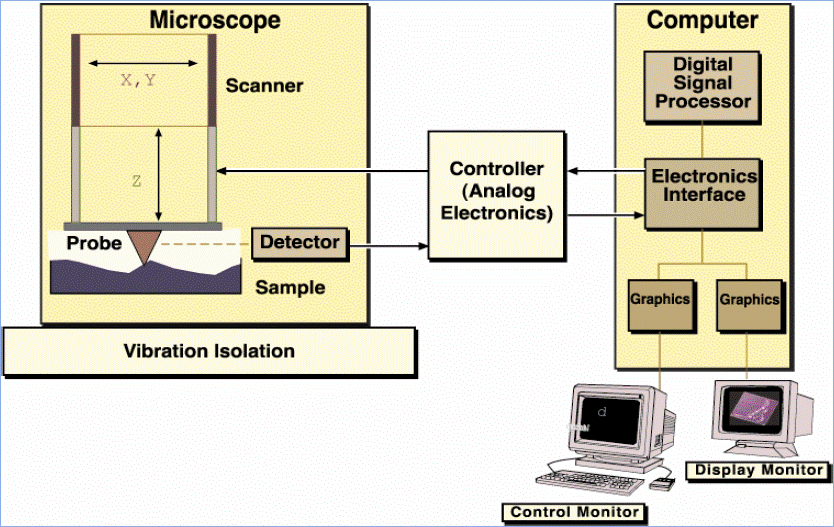
Рис.1 Основные компоненты сканирующего зондового микроскопа.
После установления баланса начинается сканирование. Зонд движется строка за строкой над определенным участком поверхности заданной площади, которая определяется числом строк-сканов, их длиной и расстоянием между строками. Движение осуществляется с помощью пьезоманипулятора. Изменение его размеров под влиянием приложенной разности потенциалов пе ремещает образец в трех направлениях.
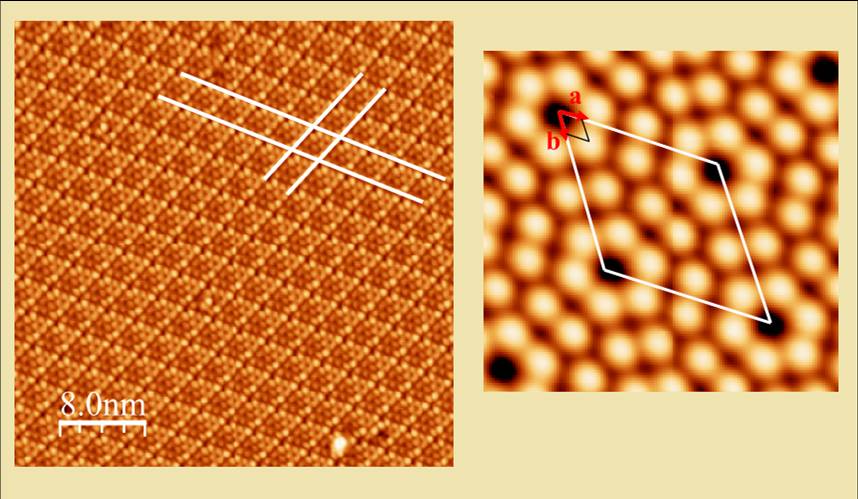
Рис. 2 Структура поверхности Si (111) 7x7
Все сканирующие зондовые микроскопы характеризуются наличием некоторого выбранного типа взаимодействия между зондом и образцом, которое используется системой обратной связи для фиксации расстояния зонд-образец при сканиро вании. Для обеспечения высокой разрешающей способности прибора интенсивность данного взаимодействия должна зависеть от расстояния. Для атомно-силового микроскопа (АСМ), например, этому условию удовлетворяют силы отталкивания крайних атомов зонда и образца, а для туннельного микроскопа (ЗТМ) - экспоненциальный рост величины туннельного тока с уменьшением туннельного зазора, что позволяет достигать с помощью этих приборов субнанометрового разрешения. Сигнал, поступая в компьютер и монитор, дает информацию о поверхности.
Атомно-силовой микроскоп позволяет исследовать не только проводящие объекты, но и диэлектрики. В АСМ возможен и режим прерывистого контакта. При этом используют дополнительный пьезоманипулятор, возбуждающий вынужденные колебания кантилевера. Силы взаимодействия зонда и образца, их физическая природа и характер сложны. Они определяются поверхностными и геометрическими свойствами мате риалов зонда и образца, свойствами среды, в которой ведется исследование.
Полученные сканирующей тунельной микроскопией результаты характеризуют топографию, химические и электронные свойства поверхности. С помощью сканирующего туннельного микроскопа можно не только осуществлять собственно микроскопические исследования с подробной аттестацией поверхностной структуры, но и зондом перемещать отдельные атомы по поверхности, то есть проводить модификацию поверхности.
5.2 Дифракционные методы
Эти методы включают дифракцию рентгеновских лучей и нейтронов и по сравнению с электронной микроскопией являются менее общими. В то же время анализ дифракционных рефлексов, обусловленных структурой атомов одиночных частиц, пригоден для очень малых частиц. Ширина угла рефлекса увеличивается с уменьшением размера частицы (эффект Шеррера). Меньшим размерам соответствует меньшее число решеточных плоскостей, которые дают интерференцию дифракционного пятна, а в больших кластерах обычно видно дифракционное кольцо.
Рентгенография
Взаимодействие рентгеновских лучей с кристаллами, частицами металлов, молекулами ведет к их рассеиванию. Из начального пучка лучей с длиной волны X ~ 0,5-5 A возникают вторичные лучи с той же длиной волны, направление и интенсивность которых связаны со строением рассеивающего объекта. Интен сивность дифрагированного луча зависит также от размеров и формы объекта. Поликристаллические частицы приводят к возникновению конусов вторичных лучей, каждый конус соответствует определенному семейству кристаллических плоскостей. Если кристаллики малы и их много, то конус будет сплошным, что и дает неравномерно зачерненное кольцо.
Кристалл является природной дифракционной решеткой, обладающей строгой периодичностью. Кристаллы для исследо ваний должны иметь размеры около 0,1 мм и обладать совершен ной структурой. Для установления структуры средней сложности, имеющей 50-100 атомов в элементарной ячейке, измеряют интенсивности сотен и даже тысяч дифракционных отражений. Этот процесс осуществляют, используя микроденситометры и дифрактометры, управляемые ЭВМ. Ранее на подобные операции требовались месяцы, а сейчас это можно сделать за несколько минут.
Исследуя аморфные материалы и не до конца упорядоченные частицы в поликристаллах, с помощью рентгенографии можно определять фазовый состав, размеры и ориентацию зерен (текстуру).
Широкое применение в настоящее время находит метод малоуглового рассеяния, позволяющий изучать пространственные неоднородности с размерами 5-10 A . Используют его для иссле дования пористых, мелкодисперсных материалов, сплавов.
Определение атомной структуры, включающее размер, форму, отнесение к группе симметрии, представляет собой сложный анализ и трудоемкую математическую обработку всех интенсив ностей дифракционных отражений. Рентгенография материалов — это область исследований на основе рентгеновских диф ракционных методов равновесных и неравновесных состояний материалов, фазового состава, фазовых диаграмм, остаточных напряжений и т.д.
Рентгенография наноструктурных материалов позволяет по уширению рентгеновских пиков достаточно надежно определить размеры зерен при величинах последних менее 100-150 нм. Уменьшение раз мера зерен и увеличение микродеформаций приводят к уширению рентгеновских пиков. Степень уширения оценивается по полуширине пика или с помощью отношения интегральной интенсивности рентгеновского пика к его высоте (интегральная ширина).
Значения размера зерен-кристаллитов и микроискажений кристаллической решетки можно рассчитать с помощью известных уравнений Шеррера и Вильсона по упрощенной формуле:
D ср= l /( ![]() *cos
*cos ![]() ),
),
где D ср - усредненный по объему размер кри сталлитов, ![]() - полуширина физического профиля рефлекса, l - длина волны излучения,
- полуширина физического профиля рефлекса, l - длина волны излучения, ![]() - 1/2 угла отражения.
- 1/2 угла отражения.

Рис. 3 Дифрактометр ДРОН-3

Рис.4 Дифрактометр ДРОН-7.
Дифракция нейтронов
Нейтрон - частица, подходящая по своим свойствам для анализа различных материалов. Ядерные реакторы дают тепловые нейтроны с максимальной энергией 0,06 эВ, которой соответствует волна де Бройля, соизмеримая с величинами межатомных расстояний. На этом и основан метод структурной нейтронографии. Соизмеримость энергии тепловых нейтронов с тепловыми колебаниями атомов и групп молекул используют для анализа в нейтронной спектроскопии, а наличие магнитного момента является основой магнитной нейтронографии.

Рис. 5 Реактор.
На рис. 6 приведено распределение r(r) в кристалле KH2PO4 вблизи водородной связи О - H - О. Смещение H (b =- 0,374 ·10-12 см) к одному из атомов О при T= 77 К связано с фазовым переходом KH2PO4 в сегнетоэлектрич. состояние.
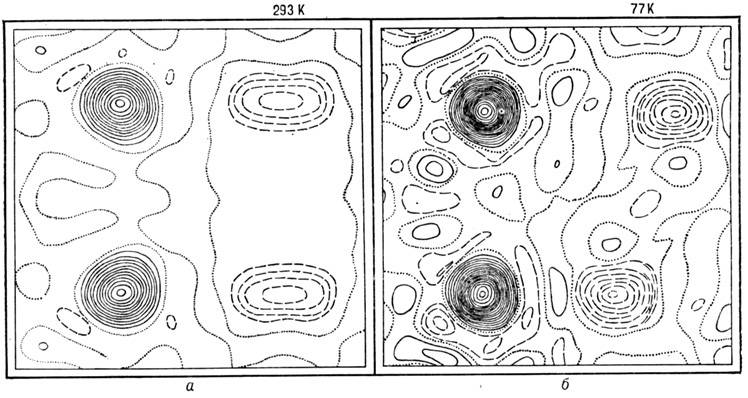
Рис.6 Фрагмент проекции плотности амплитуды рассеяния r(r) на плоскость (001) в кристалле KH2PO4 при T =293 К (а) и T= 77 К (б). Показаны 2 атома О (r >0, непрерывные линии) и два этома H (r<0, разрывные линии); точки соответствуют r = 0.
Получение достоверной информации о размерах кристаллов (слоев, включений и пор) и их распределении в наноматериале часто является весьма сложной задачей из-за ряда причин. Поэтому для анализа рекомендуется использовать как минимум два независимых метода.
Кроме того, достоверность результатов исследования наноматериалов, их физико-химических и структурных свойств существенно зависит от правильного выбора и применения методов их исследования.
